
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
Kompletní vysvětlení procesu výroby čipu (1/2): od destičky po balení a testování
2024-09-18
Výroba každého polovodičového produktu vyžaduje stovky procesů a celý výrobní proces je rozdělen do osmi kroků:zpracování oplatek - oxidace - fotolitografie - lept - nanášení tenkého filmu - propojení - testování - obal.
![]()
Krok 1:Zpracování oplatek
Všechny polovodičové procesy začínají zrnkem písku! Protože křemík obsažený v písku je surovinou potřebnou k výrobě waferů. Oplatky jsou kulaté plátky nařezané z monokrystalických válečků vyrobených z křemíku (Si) nebo arsenidu galia (GaAs). K extrakci vysoce čistých křemíkových materiálů je potřeba křemičitý písek, speciální materiál s obsahem oxidu křemičitého až 95 %, který je také hlavní surovinou pro výrobu oplatek. Zpracování oplatek je proces výroby výše uvedených oplatek.
Lití ingotů
Nejprve je třeba písek zahřát, aby se v něm oddělil oxid uhelnatý a křemík, a proces se opakuje, dokud se nezíská křemík elektronické kvality s ultra vysokou čistotou (EG-Si). Vysoce čistý křemík se roztaví do kapaliny a poté ztuhne do monokrystalické pevné formy, nazývané "ingot", což je první krok ve výrobě polovodičů.
Výrobní přesnost křemíkových ingotů (křemíkových sloupků) je velmi vysoká, dosahuje úrovně nanometrů a široce používanou výrobní metodou je Czochralského metoda.
Řezání ingotů
Po dokončení předchozího kroku je nutné odříznout dva konce ingotu diamantovou pilou a poté jej nakrájet na tenké plátky o určité tloušťce. Průměr plátku ingotu určuje velikost oplatky. Větší a tenčí wafery lze rozdělit do použitelnějších celků, což pomáhá snižovat výrobní náklady. Po naříznutí křemíkového ingotu je nutné přidat na plátky značky „plochá plocha“ nebo „promáčknutí“, aby se usnadnilo standardní nastavení směru zpracování v následujících krocích.
Leštění povrchu plátků
Plátky získané výše uvedeným procesem řezání se nazývají "holé oplatky", to znamená nezpracované "surové oplatky". Povrch holého plátku je nerovný a nelze na něj přímo vytisknout obvodový vzor. Proto je nutné nejprve odstranit povrchové defekty broušením a chemickým leptáním, poté vyleštit, aby se vytvořil hladký povrch, a poté odstranit zbytkové nečistoty čištěním, aby se získal hotový plátek s čistým povrchem.
Krok 2: Oxidace
Úlohou oxidačního procesu je vytvořit na povrchu waferu ochranný film. Chrání destičku před chemickými nečistotami, zabraňuje pronikání svodového proudu do obvodu, zabraňuje difúzi při implantaci iontů a zabraňuje sklouznutí destičky při leptání.
Prvním krokem oxidačního procesu je odstranění nečistot a kontaminantů. Vyžaduje čtyři kroky k odstranění organické hmoty, kovových nečistot a odpaření zbytkové vody. Po vyčištění lze wafer umístit do prostředí s vysokou teplotou 800 až 1200 stupňů Celsia a prouděním kyslíku nebo páry na povrchu waferu se vytvoří vrstva oxidu křemičitého (tedy „oxidu“). Kyslík difunduje oxidovou vrstvou a reaguje s křemíkem za vzniku oxidové vrstvy o různé tloušťce a její tloušťku lze měřit po dokončení oxidace.

Suchá oxidace a mokrá oxidace V závislosti na různých oxidačních činidlech v oxidační reakci lze proces tepelné oxidace rozdělit na suchou oxidaci a mokrou oxidaci. První používá čistý kyslík k výrobě vrstvy oxidu křemičitého, která je pomalá, ale vrstva oxidu je tenká a hustá. Ten vyžaduje jak kyslík, tak vysoce rozpustnou vodní páru, která se vyznačuje rychlým růstem, ale relativně silnou ochrannou vrstvou s nízkou hustotou.
Kromě oxidantu existují další proměnné, které ovlivňují tloušťku vrstvy oxidu křemičitého. Za prvé, struktura plátku, jeho povrchové defekty a vnitřní koncentrace dopingu ovlivní rychlost tvorby oxidové vrstvy. Kromě toho, čím vyšší je tlak a teplota generovaná oxidačním zařízením, tím rychleji se vytvoří vrstva oxidu. Během procesu oxidace je také nutné použít maketu listu podle polohy plátku v jednotce, aby byl plátek chráněn a snížil se rozdíl ve stupni oxidace.
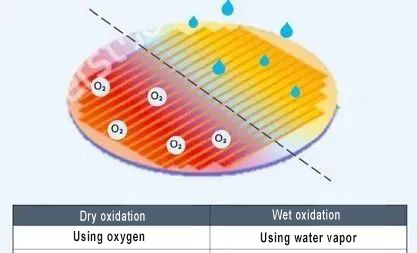
Krok 3: Fotolitografie
Fotolitografie je „tisknout“ obvodový vzor na destičku světlem. Můžeme to chápat jako nakreslení rovinné mapy potřebné pro výrobu polovodičů na povrch waferu. Čím vyšší jemnost vzoru obvodu, tím vyšší je integrace hotového čipu, které musí být dosaženo pomocí pokročilé technologie fotolitografie. Konkrétně lze fotolitografii rozdělit do tří kroků: nanášení fotorezistu, expozice a vyvolání.
Povlak
Prvním krokem nakreslení obvodu na destičku je nanesení fotorezistu na vrstvu oxidu. Fotorezist dělá z plátku "fotografický papír" změnou jeho chemických vlastností. Čím tenčí je vrstva fotorezistu na povrchu waferu, tím rovnoměrnější je povlak a tím jemnější vzor lze vytisknout. Tento krok lze provést metodou "spin coating". Podle rozdílu v reaktivitě světla (ultrafialového záření) lze fotorezisty rozdělit na dva typy: pozitivní a negativní. První z nich se po vystavení světlu rozloží a zmizí a zanechá vzor neexponované oblasti, zatímco druhý po vystavení světlu zpolymeruje a objeví se vzor exponované části.
Vystavení
Poté, co je fotorezistový film pokryt na destičce, lze tisk obvodu dokončit řízením světelné expozice. Tento proces se nazývá „expozice“. Světlo můžeme selektivně propouštět expozičním zařízením. Když světlo prochází maskou obsahující vzor obvodu, obvod lze vytisknout na destičku potaženou fotorezistním filmem níže.
Během procesu expozice platí, že čím jemnější je vytištěný vzor, tím více součástí může konečný čip pojmout, což pomáhá zlepšit efektivitu výroby a snížit náklady na každou součást. V této oblasti je novou technologií, která v současnosti přitahuje velkou pozornost, EUV litografie. Společnost Lam Research Group společně se strategickými partnery ASML a imec vyvinula novou technologii fotorezistu se suchým filmem. Tato technologie může výrazně zlepšit produktivitu a výtěžnost procesu expozice litografie EUV zlepšením rozlišení (klíčový faktor při jemném doladění šířky obvodu).
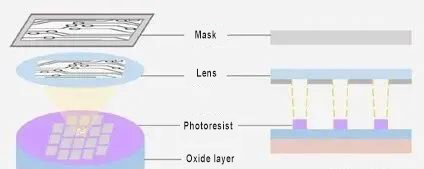
Rozvoj
Krok po expozici je nastříkání vývojky na wafer, účelem je odstranění fotorezistu v nepokryté oblasti vzoru, aby bylo možné odhalit vzor plošného spoje. Po dokončení vývoje je potřeba jej zkontrolovat různými měřicími zařízeními a optickými mikroskopy, aby byla zajištěna kvalita schématu zapojení.
Krok 4: Leptání
Po dokončení fotolitografie schématu zapojení na destičce se použije proces leptání, aby se odstranil přebytečný oxidový film a zůstalo pouze polovodičové schéma zapojení. K tomu se používá kapalina, plyn nebo plazma k odstranění vybraných přebytečných částí. Existují dva hlavní způsoby leptání v závislosti na použitých látkách: mokré leptání pomocí specifického chemického roztoku k chemické reakci za účelem odstranění oxidového filmu a suché leptání pomocí plynu nebo plazmy.
Mokré leptání
Mokré leptání za použití chemických roztoků k odstranění oxidových filmů má výhody nízké ceny, rychlé rychlosti leptání a vysoké produktivity. Mokré leptání je však izotropní, to znamená, že jeho rychlost je v každém směru stejná. To způsobuje, že maska (nebo citlivý film) není zcela zarovnána s leptaným oxidovým filmem, takže je obtížné zpracovat velmi jemná schémata zapojení.

Suché leptání
Suché leptání lze rozdělit do tří různých typů. První je chemické leptání, které využívá leptací plyny (hlavně fluorovodík). Stejně jako mokré leptání je tato metoda izotropní, což znamená, že není vhodná pro jemné leptání.
Druhou metodou je fyzikální naprašování, které využívá ionty v plazmatu k dopadu a odstranění přebytečné vrstvy oxidu. Jako metoda anizotropního leptání má leptání naprašováním různé rychlosti leptání v horizontálním a vertikálním směru, takže jeho jemnost je také lepší než chemické leptání. Nevýhodou této metody je však to, že rychlost leptání je pomalá, protože zcela závisí na fyzikální reakci způsobené srážkou iontů.
Poslední třetí metodou je reaktivní iontové leptání (RIE). RIE kombinuje první dvě metody, to znamená, že při použití plazmatu pro ionizační fyzikální leptání se chemické leptání provádí pomocí volných radikálů vzniklých po aktivaci plazmatu. Kromě rychlosti leptání přesahující první dvě metody může RIE využívat anizotropní charakteristiky iontů k dosažení vysoce přesného leptání vzoru.
Today, dry etching has been widely used to improve the yield of fine semiconductor circuits. Maintaining full-wafer etching uniformity and increasing etching speed are critical, and today's most advanced dry etching equipment is supporting the production of the most advanced logic and memory chips with higher performance.

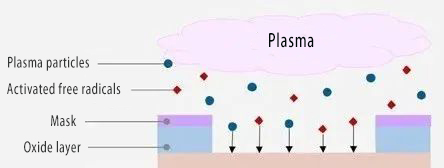
VeTek Semiconductor je profesionální čínský výrobcePovlak z karbidu tantalu, Povlak z karbidu křemíku, Speciální grafit, Keramika z karbidu křemíkuaOstatní polovodičová keramika. VeTek Semiconductor se zavazuje poskytovat pokročilá řešení pro různé produkty SiC Wafer pro polovodičový průmysl.
Máte-li zájem o výše uvedené produkty, neváhejte nás kontaktovat přímo.
Mob: +86-180 6922 0752
WhatsAPP: +86 180 6922 0752
E-mail: anny@veteksemi.com




